集束イオンビーム走査型電子顕微鏡Focused Ion Beam Scanning Electron Microscopes (FIB-SEM)

- 装置名
- ZEISS製 Crossbeam 550
- 装置の仕様
- 加速電圧:SEM 0.02~30kV / FIB 0.5~30kV
- プローブ電流範囲:
- SEM 10pA~40nA
- FIB 1pA~100nA
- 電子銃:ショットキー電界放出型
- 検出器:SESI, InLensSE, EsB, STEM
- 元素分析装置
- EDX(Oxford Instruments製 Uitim® Max 40)
FIB-SEMは、集束したGaイオンを試料に照射しスパッタリング加工を行う集束イオンビーム(FIB)と、電子線を試料に照射し観察を行う走査型電子顕微鏡(SEM)を一体化させた複合装置です(図1)。SEMにより観察を行いながら、FIB加工が可能なため、微細な異物や空隙などを捉えることが可能となり、欠陥解析や故障解析に活用されます。
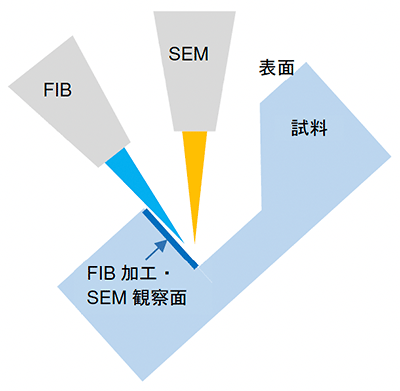
図1 FIB-SEMの概要図
また、図2の事例のようにFIB加工とSEM観察を繰り返し行い、得られた多数の連続SEM像(図2(a))をコンピューター処理することで、3次元画像(図2(b))として観察することができます。
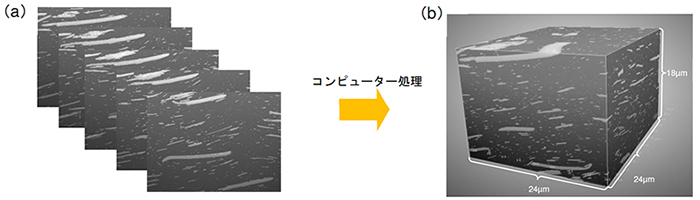
図2 FIB-SEMによる自動車用樹脂の3次元観察(a)多数の連続SEM像、(b)3次元画像