封止樹脂中のフィラーの分散状態観察(FIB-SEMによる三次元解析)
スマートフォンや携帯ゲーム機をはじめとする携帯機器には、はんだボールによって配線基板上の電極に接続されるBGA(Ball Grid Array)やCSP(Chip Size Package)が多数使用されています。これらの接続信頼性を向上させるために、封止樹脂(アンダーフィル)が使用されています。封止樹脂に含まれる無機フィラーの充填状態や分散状態は、この接続信頼性に大きく影響します。本資料では、封止樹脂中のフィラーの分散状態をFIB-SEMにより三次元的に解析した事例をご紹介します。
分析試料
- 無機フィラーを含む封止樹脂
分析方法
FIB-SEM(Zeiss製Crossbeam 550)を用いて、封止樹脂の加工・観察を100nmステップにて300回繰り返し、取得した画像から三次元モデルを構築、画像解析を行い、フィラーの体積ごとの分布と体積比率を求めました。
分析結果
三次元画像構築結果を図1、解析結果を表1に示します。樹脂内には不定形と球状のフィラーが含まれました。全体積に対して、球状は約40vol%を占めており、不定形は極微量であることが分かりました。

図1 三次元構築画像
| 体積(μm3) | 割合(vol%) | |
|---|---|---|
| 樹脂部 | 7,339 | 59 |
| 球状フィラー部 | 5,041 | 41 |
| 不定形フィラー部 | 40 | <1 |
| 総体積 | 12,421 | 100 |
球状フィラーの体積分布について解析した結果を表2と図2に示します。体積和では0.1~1μm3のフィラーが全体の約60%、個数では0.01~0.1μm3のフィラーが全体の約47%を占めていました。
| 体積(μm3) | <0.001 | 0.001-0.01 | 0.01-0.1 | 0.1-1 | >1 |
|---|---|---|---|---|---|
| 体積和(μm3) | 2 | 65 | 1,055 | 3,019 | 900 |
| 体積和(%) | <1 | 1 | 21 | 60 | 18 |
| 個数(個) | 4,298 | 13,900 | 26,601 | 11,611 | 535 |
| 個数(%) | 8 | 24 | 47 | 20 | 1 |

図2 球状フィラーの体積分布
さらに、球状フィラーの体積ごとの分散状態が分かりました(図3)。
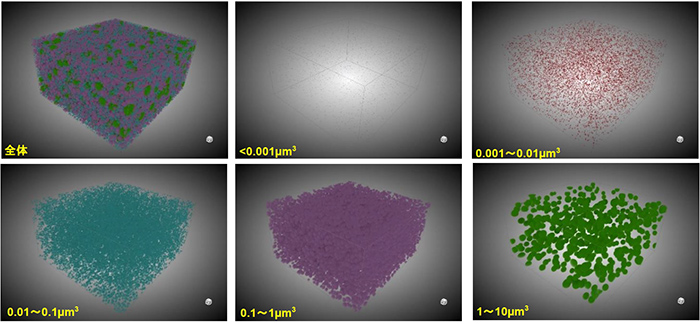
図3 フィラーの体積ごとの分散状態
このように、画像解析を行うことにより、樹脂に配合したフィラーの定量的な評価が可能となります。