XPSによる酸化膜付Siウエハの深さ方向分析
X線光電子分光(XPS)は、表面から数nmのごく浅い領域しか分析できませんが、イオンスパッタリングを併用することで、より深い領域までの深さ方向分析が可能になります。深さ方向分析では、元素組成や化学状態の深さ方向の分布などが分かり、層構成や膜厚などの情報も評価できます。ここでは、Arイオンスパッタを用いた酸化膜付Siウエハの深さ方向分析の事例を紹介します。
分析試料
- 酸化膜付Siウエハ
分析方法
XPS(単色化AlKα線)、スパッタイオン種:Arイオン
分析結果
XPS測定で取得したSi2pスペクトルを図1に、デプスプロファイルを図2に示します。 図1から、スパッタサイクル、すなわちスパッタ時間の増加に伴ってピーク位置が103eV付近から99eV付近にシフトすること、また図2から、OとSiの原子数比(O/Si)が2から0に変化することが確認されました。そのため、基材がSiで表面にSiO2層がある構造であることがデータから確認できます。また、スパッタリングレートが既知の場合は、デプスプロファイルの横軸を「スパッタ時間」から「深さ」に換算することができます。図2において換算した結果、SiO2膜の厚みは約100nmであることが確認されました。
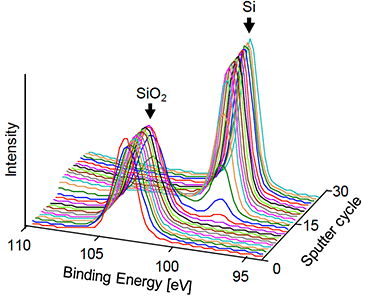
図1 Si2pスペクトル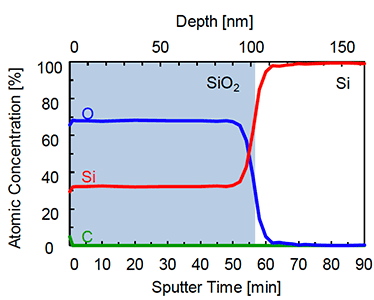
図2 デプスプロファイル