Ar-GCIBを用いたXPSによるポリイミドフィルムの表面分析
Arガスクラスターイオンビーム(Ar-GCIB)を使用することにより、従来のAr単原子イオンビームスパッタでは困難であった有機物表面の低損傷スパッタ処理が可能となります。大気中に曝された試料についてX線光電子分光(XPS)分析を行う場合、表面状態に敏感な分析であることから、測定結果は表面汚染層の影響を強く受けてしまいます。そのため、試料本来の状態を評価するためには試料を損傷させずに表面汚染層を除去する必要があります。
ここでは、Ar-GCIBスパッタによりポリイミド表面にある厚さ数nmの表面汚染層を除去し、XPSにより下地のポリイミドの組成と化学結合状態に関する分析を実施した事例を紹介します。
分析試料
- ポリイミドフィルム
分析方法
XPS(単色化AlKα線)
分析結果
分析の結果、水準間でC1sスペクトル形状(図1)、および元素組成(表1)が異なることが確認されました。C1sスペクトルにおいて、最表面およびAr単原子イオンビームスパッタ後ではイミド結合に由来するピークが観測されませんでした。この理由は、最表面では表面汚染層の影響でポリイミドの情報が埋もれてしまったと考えられ、Ar単原子イオンビームスパッタ後ではスパッタにより分子構造が破壊されてしまったと考えらえます。これに対して、Ar-GCIBスパッタ後では、イミド結合を検出し、本来の構造を反映した組成比を示しました。
このように、Ar-GCIBスパッタを適用することで、通常存在する表面汚染層を除去して試料の本来の状態を分析することができます。
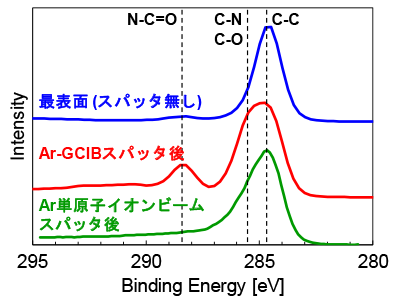
図1 C1sスペクトル
表1 元素組成
