スイッチ接点部表面における低分子シロキサン付着の評価(XPS)
低分子シロキサンは電子部品や光学部品に悪影響を及ぼすことが知られています。スイッチやモーターにおいては、スイッチ動作時に発生したアークによって表面に付着した低分子シロキサンがシリカに化学変化し、接点障害を引き起こします。X線光電子分光(XPS)はSi元素の有無に加えて、Siの化学結合状態も評価可能であるため、低分子シロキサン付着の評価に非常に有効な分析手法です。ここでは、リレースイッチの接点部表面のXPS分析を行い、低分子シロキサンの付着や形成するシリカを評価した事例を紹介します。
分析試料
- リレースイッチの接点部(図1参照)
-
- 試料①:未処理
- 試料②:試料①と市販のシリコーン樹脂を密閉容器に入れて動作させずに静置したもの(試料①から外観の変化は無し)
- 試料③:低分子シロキサンの発生雰囲気下で、接点部表面が変色するまでスイッチ動作をさせたもの
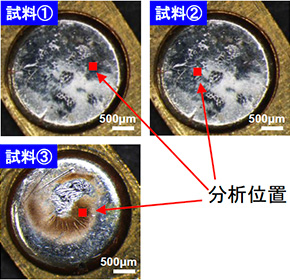
図1 試料外観(光学像)
分析方法
- XPS;単色化AlKα線(アルバック・ファイ製 PHI5000 VersaProbe II)
分析結果
1. 各試料の状態評価
図2に試料①~③のSi2pスペクトルを示します。試料②、③からSiが検出されました。ピークの結合エネルギー値から、試料②の表面にはシリコーン樹脂から発生した低分子シロキサンが付着したことが示されました。これに対して試料③では、低分子シロキサン由来のピークとシリカ由来のピークが重ね合わさったピークが観測されたことから、試料③の表面では付着した低分子シロキサンからシリカが生成していることが示されました。
なお、試料②のAg4sピークが試料①と同程度の強度で観測されたため、試料②に付着した低分子シロキサンの厚みは数nmと推測されます。
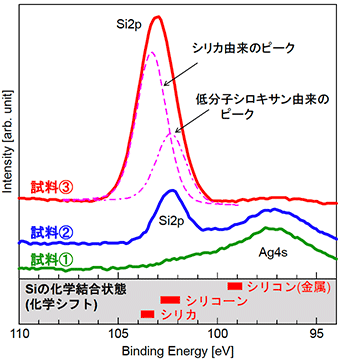
図2 各試料のSi2pスペクトルと化学シフト
2. 低分子シロキサンとシリカの分布状態の評価
試料③の表面のXPSマップ測定を実施しました。図3にSiの低分子シロキサンおよびシリカのXPS状態マップ、およびAgのXPS元素マップを示します。図3から低分子シロキサン、シリカともに主に変色部分に分布していますが、シリカは変色部分のみに分布しているのに対して、低分子シロキサンは接点部全面に分布していることが確認できます。
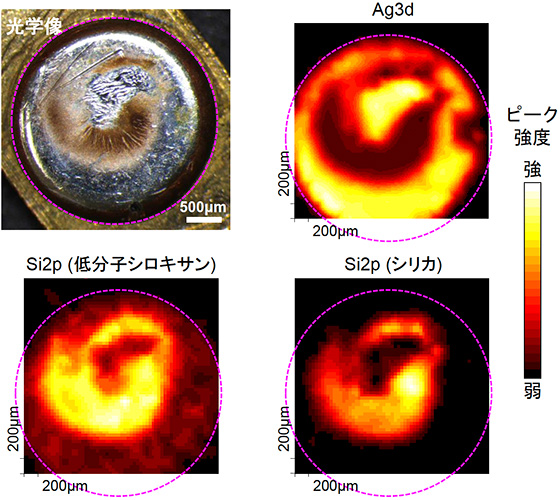
図3 試料③の(a)光学像および表面のXPSマップ(b)~(d)(点線内部がスイッチの接点部に対応)
このようにXPSでは、微量(数nmの厚さ)であっても、スペクトルから低分子シロキサンとシリカを判別することが可能であり、マップ測定を行うことで元素ごとだけではなく、化学結合状態ごとの分布を可視化・評価することができます。