半導体デバイスの構造解析
半導体デバイスは、Si基板上にトランジスタ等の電子回路を形成した複雑な構成となっており、近年、大容量化、サイズの縮小化に伴い、デバイスの微細化が進んでいます。その構造を明確化するため、FIBを用いた加工、TEMによる構造解析をした事例をご紹介します。
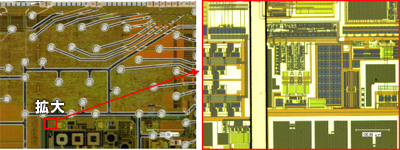
図1 半導体デバイスの構造(光学顕微鏡像)
FIB加工により断面を作製し、SIM(Scanning Ion Microscope)による形態観察を行いました。
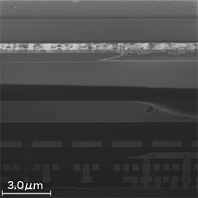
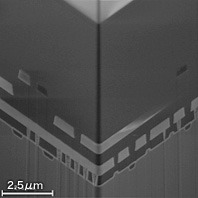
図2 断面観察(SIM像)
FIB加工により、TEM用薄膜試料を作製後、TEM−EDXにより元素分析(点分析)、元素マッピング分析(面分析)を実施しました。
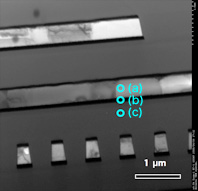
図3 断面観察(TEM像)

図4 点分析結果(TEM-EDX)
面分析は、試料面上で電子線プローブの位置情報と特性X線スペクトルを同期させて、二次元の元素分布情報を得る手法です。

図5 面分析結果